|
||||
|
||||
 |
�����Ј������c���g(sh��)�M(j��n)����LED�a(ch��n)�I(y��)�l(f��)չ�ăɴ��(d��ng)�����^ȥ��?y��n)�a(ch��n)Ʒ���ʺ����a(ch��n)�ɱ���ԭ����LED���g(sh��)ֻ���ٔ�(sh��)�S�����������a(ch��n)Ʒ���S��LED�Ј��ļ��Ҡ��Z�����ُS�̞隢���؇��_ʼͶ�븲��LED��
����Ŀǰ���b���g(sh��)�ɷ֞����b�c�������������ֿɷ֞��������͟o�����ɷN�������������Ѓ�(y��u)ȱ�c(di��n)��
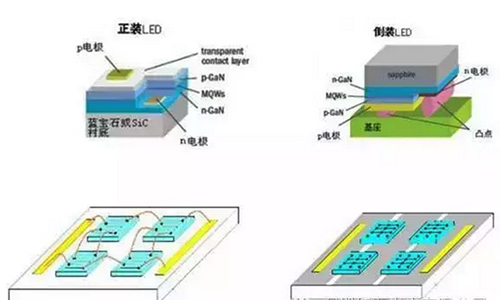
���������bоƬ���b�������y�z����z��оƬ�̶��ڻ����ϣ�ͨ�^������(sh��)�F(xi��n)늚��B�ӡ��y�z����z���h(hu��n)����֬���L�ڭh(hu��n)����(w��n)�����^�������^�ߣ���LED�L�r(sh��)�gͨ��^����ճ������u׃���(d��o)��LED�����s��;�������ܼ�(x��)���ʹ�����_�������^��H�ܳ���10g���ҵ�����������(d��ng)�ܵ����_���r(sh��)������N���b���ϵğ�ʧ�䣬��(d��o)���������яĶ�����LEDʧЧ��
������(y��u)�c(di��n)����оƬ�Ƃ乤ˇ����;�ڷ��b��ˇ���^���졣
����ȱ�c(di��n)����늘O�����c(di��n)�������ڹ�;�ڟ����(d��o);�����L���{(l��n)��ʯճ�Y(ji��)�z֧�ܽ��ٻ���;�۟����(d��o)ϵ��(sh��)�ͣ��{(l��n)��ʯ�����(d��o)�ʞ�20W / (m��K)��ճ�Y(ji��)�z�����(d��o)�ʞ�2W/ (m��K);�ܟ�e��Ӱ�оƬ�͟ɹ�ۿɿ��ԡ�
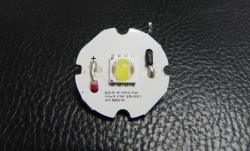
�������������������b��ͨ�^��(d��o)��ճ�Y(ji��)�z��LED���bоƬ�̶��ڻ����ϣ������ý��M(j��n)��늚��B�ӡ����е��bоƬ��ͨ�^ֲ����ķ�ʽ��LED���bоƬ���b�ڹ�(S i)�r�����ϣ�����S i�r�����Ƃ�늘O���γɵ��bоƬ��
������(y��u)�c(di��n)�����{(l��n)��ʯ�r�����ϣ��o늘O�����c(di��n)�������ڹ⣬����Ч������;�ڂ���Ч���^�ã��ׂ���(d��o)��
����ȱ�c(di��n)���ٟ����(d��o);���^�L�����ٺ��c(di��n)����������(d��o)��ճ�Y(ji��)�z��֧�ܟ��;���������B�ӣ�����������������ޣ���������̓������Ŀɿ��Ԇ��}��

�������o�����������b��ͨ�^����/�������Ӽ��g(sh��)��늘O���|��僌Ӟ��a(Sn)���(Au)-�a�ȺϽ��ˮƽ늘OоƬֱ�Ӻ�������н���y�Ļ����ϣ��ȿɹ̶�оƬ���ֿ�늚��B�Ӻ͟����(d��o)��
������(y��u)�c(di��n)���ٟo늘O�����c(di��n)�������ڹ�;�ڟo������K���Ɍ�(sh��)�F(xi��n)ƽ��Ϳ���ɹ�ۼ��������b;��늚��B�Ӟ�����|�����ʹ�����_��;�ܟ����(d��o);���̣����a���c(di��n)�������X�մ�/���ٻ���;�ݽ��ٽ��挧(d��o)��ϵ��(sh��)���ߣ������С;����ȫ�[Ó������ճ�Y(ji��)�z�����`�����F(xi��n)����(y��u)���������ᡢ�⡢����ܡ�
�����S�����ӡ�оƬ�Ƃ似�g(sh��)�l(f��)չ��ICоƬ�����b���g(sh��)��LED�еđ�(y��ng)�ã����ڸ����ğo�������b���g(sh��)���ɞ�δ�����I(l��ng)�Ј���һ�NLED���b�¼��g(sh��)��
| �O(sh��)�����
| �W(w��ng)վ���O(sh��) | �̄�(w��)��Ϣ
| LED�@ʾ���YӍ |
��վ��(d��ng)�B(t��i)
| �P(gu��n)��LED�����W(w��ng)
| �W(w��ng)վRSS | �W(w��ng)վ�؈D
| ����朽�
��վ��(sh��)����LED�����W(w��ng) | ���H������www.saemoetchemins.com ���(qu��n)����© 2009-2015 ������Ͷ�W(w��ng)�j(lu��)��Ϣ���g(sh��)����˾ ���c(di��n)�P(gu��n)�I�~��LED�@ʾ�����ƿ� | LED�@ʾ������ܛ�� | LEDȫ���@ʾ�� | led�V���� �]�䣺LED-100@3v.cn �ͷ�QQ�� |